This section contains the standard dielectric etch recipes for all GT RIE and ICP equipment: Vision RIE 2, Vision RIE 1, Oxford End-Point RIE, Unaxis 790 RIE, Plasma Therm RIE (Right Chamber), and Plasma Therm ICP (Left Chamber).
Comparison of Oxide Etch Details for GT RIE and ICP Equipment

Vision RIE 2
- Location: Marcus Cleanroom
- Etching Capabilities:
- Sample size:
- Pieces to 8” wafer
- Up to four, 4” wafers or a single 6” wafer at one time
- Standard Recipes:

(Back to top)
Vision RIE 1
- Location: Marcus Cleanroom
- Etching Capabilities:
- Sample size:
- Pieces to 8” wafer
- Up to four, 4” wafers or a single 6” wafer at one time
- Standard Recipes:

(Back to top)
Oxford End-Point RIE
- Location: Marcus Cleanroom
- Etching Capabilities:
- Sample size:
- Standard Recipes:

(Back to top)
Unaxis 790 RIE
- Location: Marcus Cleanroom
- Etching Capabilities:
- Sample size:
- Standard Recipes:

(Back to top)
Plasma Therm RIE (Right Chamber)
- Location: Petitt Cleanroom
- Etching Capabilities:
- Sample size:
- Pieces to 4” wafer
- Up to four, 4” wafers at a time
- Standard Recipes:
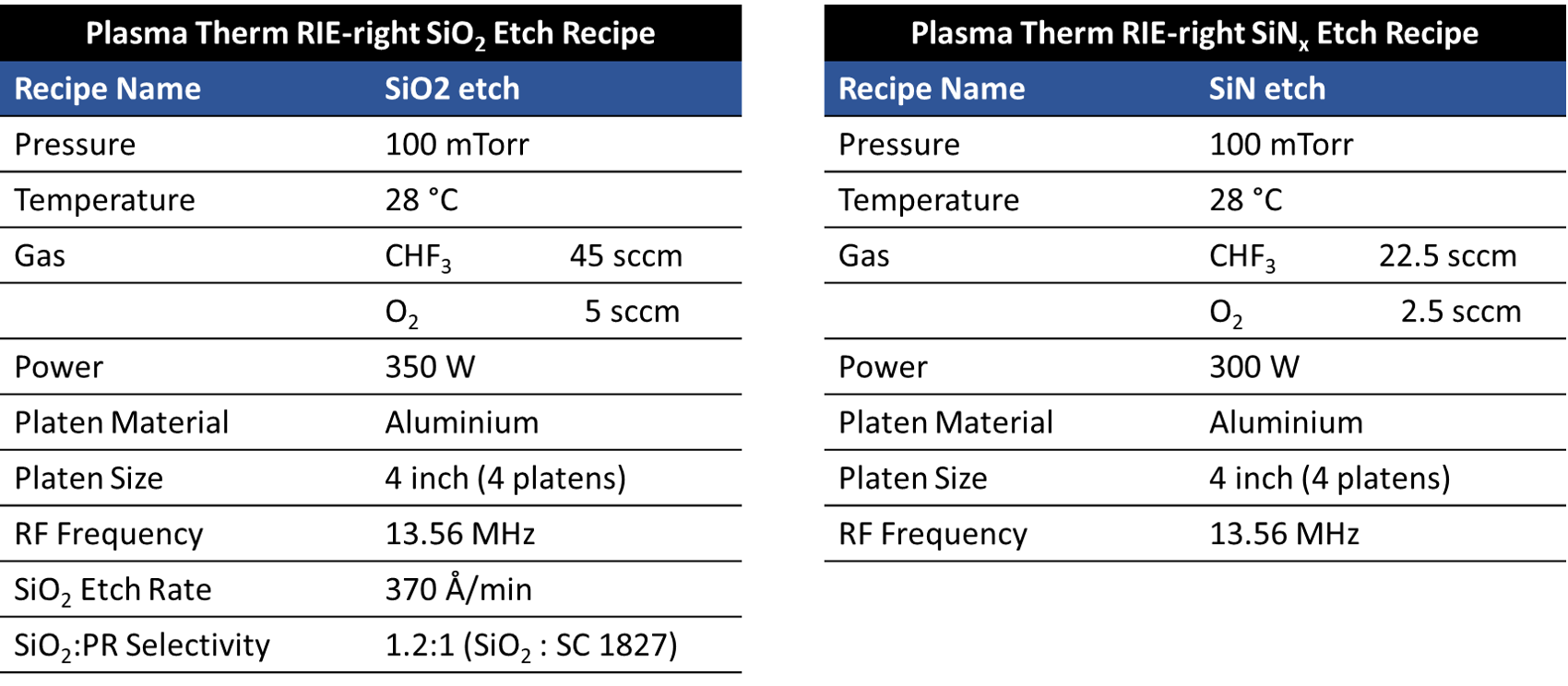
(Back to top)
Plasma Therm ICP (Left Chamber)
- Location: Petitt Cleanroom
- Etching Capabilities:
- Sample size:
- Pieces to 4” wafer. Pieces has to be placed on a four inch Si wafer with cool grease, or with a kapton tape
- Standard Recipes:

(Back to top)